【摘要】
随着微电子行业的发展,传统的电子封装技术已经不能完全满足要求,因为这种封装技术设计复杂,成本高,同时限制了IC的性能和可靠性。硅片切割工艺的效果直接影响到芯片的性能和
随着微电子行业的发展,传统的电子封装技术已经不能完全满足要求,因为这种封装技术设计复杂,成本高,同时限制了IC的性能和可靠性。硅片切割工艺的效果直接影响到芯片的性能和效益。
芯片的划片方法与典型IC的划片方法不同。常规的IC砂轮划片是通过高速旋转砂轮刀片,以完成对材料的切削,从而实现切削。因为刀片的高速旋转,经常需要用纯水来冷却和冲洗,所以刀片的高速旋转产生的压力和扭力,纯水的冲洗产生的冲击力,以及碎屑和缝隙的污染,都很容易对MEMS芯片的机械微结结构造成不可逆转的破坏。因此一般IC砂轮划片不适合MEMS晶片划片。
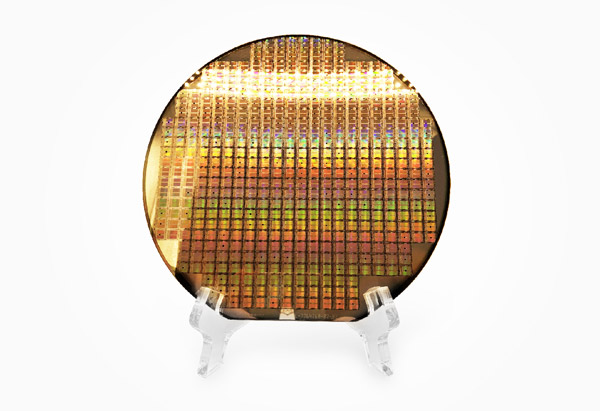
激光切割技术就是在这种情况下出现的,它被广泛地应用于MEMS晶片,RFID晶片和Memory晶片。
作为激光切割晶圆的一种方案,激光切割很好地避免了砂轮切割中的问题。利用单脉冲脉冲激光进行光学整形,使材料表面聚焦于材料内部,从而在聚焦区域内提高能量密度,从而形成多光子吸收的非线性吸收效应,从而使材料改性产生裂纹。每个激光脉冲都等距作用,形成等距损伤就可以在材料中形成改质层。改变层中材料的分子键被破坏,材料之间的连接变得脆弱且容易分离。切削完毕后通过拉伸承载膜的方式,使产品完全分离,并使芯片和芯片之间产生间隙。这种处理方式避免了由机械直接接触和纯水冲刷造成的损坏。
莱塞激光切割技术可以用于蓝宝石/玻璃/硅和许多半导体晶片等化合物。
| 免费提供解决方案/免费打样 18565508110
下一篇:手机薄膜激光切割机的应用